 先进材料表征
先进材料表征

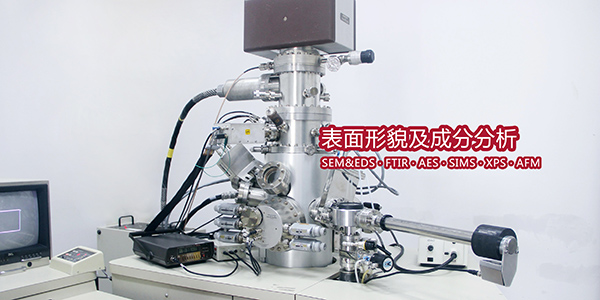
1. 飞行时间二次离子质谱技术
二次离子质谱技术(Dynamic Secondary Ion Mass Spectrometry,D-SIMS)是一种非常灵敏的表面分析技术,通过用一次离子激发样品表面,打出极其微量的二次离子,根据二次离子的质量来测定元素种类,具有极高分辨率和检出限的表面分析技术。D-SIMS可以提供表面,薄膜,界面以至于三维样品的元素结构信息,其特点在二次离子来自表面单个原子层(1nm以内),仅带出表面的化学信息,具有分析区域小、分析深度浅和检出限高的特点,广泛应用于物理,化学,微电子,生物,制药,空间分析等工业和研究方面。
2. 动态二次离子质谱分析(D-SIMS)可为客户解决的产品质量问题
(1)当产品表面存在微小的异物,而常规的成分测试方法无法准确对异物进行定性定量分析,可选择D-SIMS进行分析,D-SIMS能分析≥10μm直径的异物成分。
(2)当产品表面膜层太薄,无法使用常规测试进行膜厚测量,可选择D-SIMS进行分析,利用D-SIMS测量≥1nm的超薄膜厚。
(3)当产品表面有多层薄膜,需测量各层膜厚及成分,利用D-SIMS能准确测定各层薄膜厚度及组成成分。
(4)当膜层与基材截面出现分层等问题,但是未能观察到明显的异物痕迹,可使用D-SIMS分析表面超痕量物质成分,以确定截面是否存在外来污染,检出限高达ppb级别。
(5)掺杂工艺中,掺杂元素的含量一般是在ppm-ppb之间,且深度可达几十微米,使用常规手段无法准确测试掺杂元素从表面到心部的浓度分布,利用D-SIMS可以完成这方面参数测试。
3. 动态二次离子质谱分析(D-SIMS)注意事项
(1)样品最大规格尺寸为1×1×0.5cm,当样品尺寸过大需切割取样,样品表面必须平整。
(2)取样的时候避免手和取样工具接触到需要测试的位置,取下样品后使用真空包装或其他能隔离外界环境的包装, 避免外来污染影响分析结果。
(3)D-SIMS测试的样品不受导电性的限制,绝缘的样品也可以测试。
(4)D-SIMS元素分析范围H-U,检出限ppb级别。
4.应用实例
样品信息:P92钢阳极氧化膜厚度分析。
分析结果:氧化膜厚度为20μm,从表面往心部成分分布:0-4μmFe2O3,4-9μmFe3O4,9-15μm(Fe.Cr)3O4,15-20μm合金化混合区。