 先进材料表征
先进材料表征

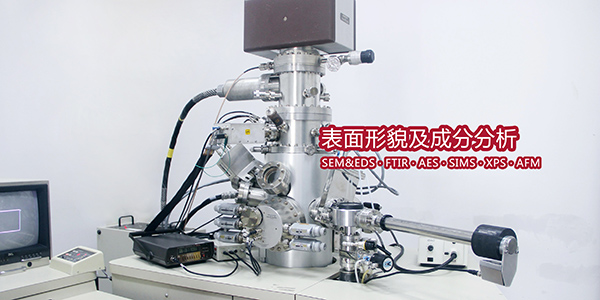
1、聚焦离子束技术(FIB)
聚焦离子束技术(Focused Ion beam,FIB)是利用电透镜将离子束聚焦成非常小尺寸的离子束轰击材料表面,实现材料的剥离、沉积、注入、切割和改性。随着纳米科技的发展,纳米尺度制造业发展迅速,而纳米加工就是纳米制造业的核心部分,纳米加工的代表性方法就是聚焦离子束。近年来发展起来的聚焦离子束技术(FIB)利用高强度聚焦离子束对材料进行纳米加工,配合扫描电镜(SEM)等高倍数电子显微镜实时观察,成为了纳米级分析、制造的主要方法。目前已广泛应用于半导体集成电路修改、离子注入、切割和故障分析等。
2. 聚焦离子束技术(FIB)可为客户解决的产品质量问题
(1)在IC生产工艺中,发现微区电路蚀刻有错误,可利用FIB的切割,断开原来的电路,再使用定区域喷金,搭接到其他电路上,实现电路修改,最高精度可达5nm。
(2)产品表面存在微纳米级缺陷,如异物、腐蚀、氧化等问题,需观察缺陷与基材的界面情况,利用FIB就可以准确定位切割,制备缺陷位置截面样品,再利用SEM观察界面情况。
(3)微米级尺寸的样品,经过表面处理形成薄膜,需要观察薄膜的结构、与基材的结合程度,可利用FIB切割制样,再使用SEM观察。
3. 聚焦离子束技术(FIB)注意事项
(1)样品大小5×5×1cm,当样品过大需切割取样。
(2)样品需导电,不导电样品必须能喷金增加导电性。
(3)切割深度必须小于50微米。
4.应用实例
(1)微米级缺陷样品截面制备
(2)PCB电路断裂位置,利用离子成像观察铜箔金相。