 模拟仿真
模拟仿真
热循环测试(Thermal Cycling)是衡量电子产品焊接可靠性最常见的测试。以63.2%的统计寿命来计算焊球寿命。失效发生后,失效分析手段(切片、红墨水、SEM/EDS、X-Ray等)就用来检查失效位置及失效类型。
测试标准
1) JEDEC Standard JESD22-A104 Thermal Cycling
2) IPC 9701 Performance Test Methods and Qualification Requirements for Surface Mount Solder Attachments
有限元仿真模拟可以用来测试产品的理论寿命,通过软件计算提前预知产品的可靠性,并对失效的机理进行分析,提前规避失效风险,从而优化产品设计,提供可靠性。
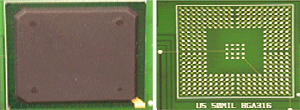 |
 |
| 产品及焊球Layout | 焊球开裂现象 |
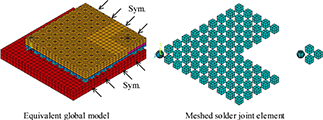 |
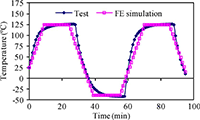 |
| 有限元模型 | 仿真测试中的温度曲线 |
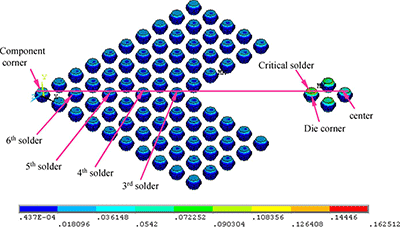 |
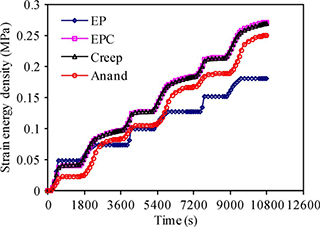 |
| 一个热循环后焊球的塑性应变能分布 | 不同等效模型的应变能密度变化 |
 |
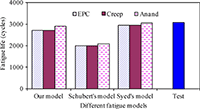 |
| 采用不同的计算区域来预测热循环寿命 | 不同寿命预测方法获取的焊球热循环寿命比较 |
▽ 芯片弯曲循环测试及寿命预测
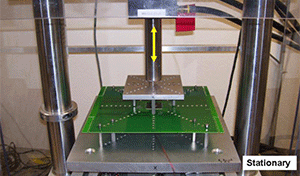 |
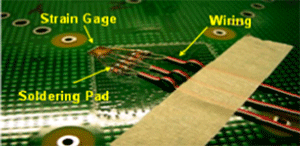 |
| 试验装置 | 传感器安装在PCB板的背面 |
 |
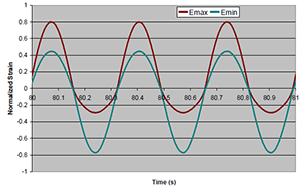 |
| 菊花链测试电阻监控焊球是否开裂(电阻上升100%) | 传感器获取的弯曲频率下的PCB的应变幅值 |
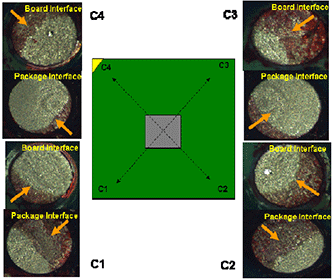 |
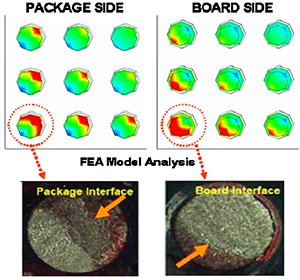 |
| 测试完成后的红墨水验证试验 | 仿真计算结果和红墨水试验一致 |
| 传感器应变值 | ||||
| 500ue | 750ue | 1000ue | ||
| 弯曲循环试验测试 | 弯曲位移(mm) | 0.9 | 1.26 | 1.74 |
| 平均寿命(次) | 100k+ | 26412 | 10064 | |
| 数值仿真测试 | 等效应变(体积平均) | 5.16E-5 | 4.39E-4 | 1.28E-3 |
| 弯曲位移 | 0.918 | 1.400 | 1.904 | |
| 计算寿命 | 177284 | 29389 | 11924 | |
▽ 芯片加速度冲击仿真测试
.jpg) |
.jpg) |
| 半正弦波冲击测试 | 方波冲击测试 |
.jpg) |
(1).png) |
| 应变传感器 | PCB板在半正弦波冲击下的应变响应 |
▽ 芯片及元器件随机振动条件下的寿命预测
.png)
▽ 不同层叠结构及核心材料下的PCB板材料参数
| PCB Thickness | Polymer Core Material | PCB Data | 芯片焊球寿命(热循环次数) | |||||||
| material number | CTE x | CTE y | CTE z | Flexural Modulus |
CTEx/ CTEy |
CTEz | Ex/Ey | Ez | ||
| 1.57 | EM370 | 12 | 15 | 40 | 24000 | 16.3 | 36.64 | 38166.5 | 28419.35 | 6500 |
| 1.608 | EM355 | 12 | 15 | 40 | 22000 | 17.03 | 34.98 | 43807.22 | 28923.65 | 5800 |
| 1.575 | FR4 | 17 | 17 | 60 | 17689 | 18.25 | 51.64 | 34765.76 | 21769.76 | 2850 |
▽ PCB板的翘曲会引起元器件受力集中

翘曲引起焊接变形,从而降低可靠性
▽ 不同封装结构的电阻元件寿命表现及其原理
.jpg)
(1).png) |
(1).png) |
▽ 焊球拉拔力测试
不同IMC厚度对焊球拉拔力的影响
.png)
| IMC厚度(um) | 焊球开裂时的拉力(N) | |
| Cu3Sn | Cu6Sn5 | |
| 1 | 2 | 21.32 |
| 2 | 4 | 16.66 |
| 3 | 7 | 15.25 |
▽ 温度循环条件下的焊料寿命计算
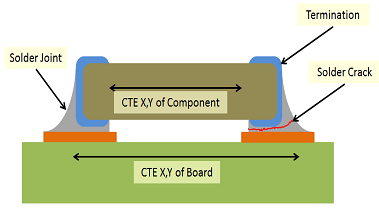 |
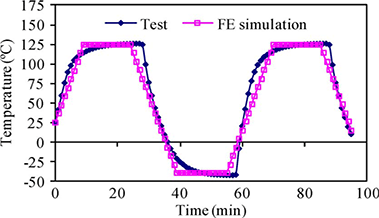 |
| 引脚开裂原理 | 仿真测试中的温度曲线 |
| 序号 | 焊料外形 | 累计应变能 (N.mm) |
剪切应变幅值 (mm) |
寿命 (循环次数) |
| 1 | 凹状 | 0.00030 | 2.45e-3 | 5786 |
| 2 | 轻微凹陷 | 0.00021 | 1.84e-3 | 9120 |
| 3 | 轻微凸起 | 0.00028 | 2.22e-3 | 6166 |
| 4 | 凸起 | 0.00033 | 2.87e-3 | 5214 |
▽ ICT治具仿真测试